AFM, Bruker Dimension Icon

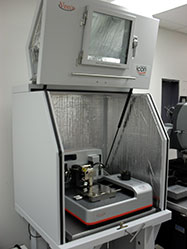
Atomic Force Microscope (AFM): Bruker Dimension Icon
AFM provides:
- Standard technique for surface analysis of materials
- Resolution greater than 1000 times than optical diffraction limit
- High-resolution imaging of surface features at angstrom scales
- Piezoelectric ceramics for accurate scan head control
- Analysis in fluid cells and in controlled environments
- Atomic-scale surface manipulation and modification
- Quantitative measurement of surface roughness
- Elastic modulus ranges from ~1 MPa to 50 Gpa
- Adhesion forces ranges from ~10 pN to 10 N
Available Modes:
- · Contact mode
- · Tapping mode
- · Veeco ScanAsyst and PeakForce™ Tapping Mode
- · Magnetic Force Microscopy
- · Fluid Cell Imaging
- · Special deep trench probe for high aspect ratio imaging.
- · The AFM supports other modes of operations. Contact staff for available modes. User must provide own specialized tips.
Future Upgrades (contact staff for more information):
- Expansion of capabilities for Kelvin Probe Force Microscopy
- Scanning Capacitance Microscopy (SCM) and Scanning Spreading Resistance Microscopy (SSRM) for resistivity measurements with upgrade.
Sample Requirements:
- The sample platen can take up to 200mm diameter samples.
- The maximum Z scanning height is of the order of 5µm.
- The maximum height of a sample is of the order of 12mm.
- Maximum height of a sample is approximately 12mm.
Publications:
Training available by request. Please contact Dr. Brian Van Devener if you are interested in signing up for a training session.
Contact Information
Dr. Brian Van Devener
Phone: (801) 587-3108
Email:bvandev@chem.utah.edu
Last Updated: July 27,2011